我们能够享受现代电子设备小巧玲珑但又功能强大的优点,得益于芯片的小型封装的优势,其中一个最为优秀的封装形式就是锡球阵列封装(BGA)。这种封装形式芯片的管脚是分布于芯片底部的一系列点阵排列的焊盘,通过均匀的锡球与PCB板连接在一起。
比起通过传统芯片两边或者四周引线管脚封装,BGA封装极大提高了芯片引脚的数量,同时缩短了引脚与电路板之间的距离。密集的锡球连接也大大改善了芯片的散热能力。
BGA的返修,通常是为了除去功能、引线损坏或者排列错误的元器件,重新更换新的元器件。或者说,就是使不合格的电路组件恢复与特定要求相一致的合格的组件。手工返修时必须小心谨慎,其基本的原则是不能使电路板、元器件过热,否则极易造成电路板的电镀通孔、元件和焊盘的损伤。
返修BGA
1、清理焊盘:如果BGA刚拆下,最好在最短的时间内清理PCB和BGA的焊盘,因为此时PCB板与BGA未完全冷却,温差对焊盘的损伤较小。
2、BGA植球(此处需要使用德正智能植球台、对应大小的锡球、与BGA匹配的钢网)
3、BGA锡球焊接:设置加热台的焊接温度(有铅约230℃,无铅约250℃),将植珠完的BGA放在加热台焊接区的高温布上,并使用热风筒进行加热。待BGA的锡球处于熔融状态,且表面光亮,有明显液态感,锡球排列整齐,此时将BGA移至散热台,让其冷却,焊接完成。
手机内部多层电路板以及BGA封装芯片这种封装给电路板的维修带来了巨大的挑战。芯片的拆卸与重新安装比起普通带有引脚的芯片都困难。特别是BGA封装的芯片一经拆卸,它底部的锡球均会遭到破坏。在重新焊接的时候,需要通过特殊的工具重新种植锡球。
为了保证每个锡球能够对准芯片底部的焊盘,则需要借助于精密的钢丝网的帮助。这些钢丝网一般通过激光雕刻而成。
植球钢网与热风焊台在B站看到一个手工焊接BGA封装芯片的视频。其精细过程令人惊叹。
视频中的芯片是没有锡球的苹果手机主芯片,在一平方厘米见方内大有有1000多个管脚。视频展示了手工重置锡球和焊接过程完整18个步骤,相信看完之后,会让人对于焊接过程有了新的理解。
1. 首先将配套的钢网敷在芯片底部的管脚上面,然后将焊锡膏均匀涂抹在钢网上面,并用力压紧。
涂抹焊锡膏2. 然后在使用软布将钢网上剩余的焊锡膏清理干净。观察是否所有的管脚内都包含有均匀的焊锡膏。

抹平焊锡膏表面3. 使用尖嘴镊子将上面四个核心定位焊盘内的焊锡膏剔除。

去除核心焊盘中的焊锡膏4. 接着,使用热风枪加热钢网和芯片,直到所有的焊锡膏都融化,并形成球状。

使用热风枪融化焊锡膏5. 使用助焊剂涂抹在钢网上,然后再次进行加热。这样可以使得所形成的锡球更加的均匀。
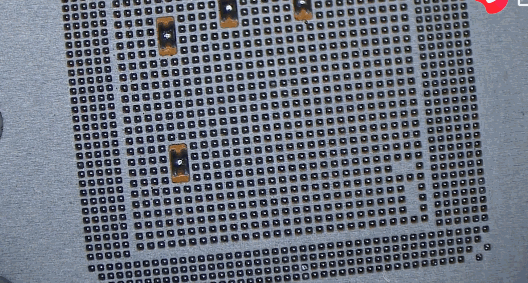
涂抹助焊剂之后再加热6. 通过使用尖嘴镊子按动定位核心孔将钢网和芯片分离开来。

将钢膜从芯片上脱落7. 使用吸锡铜丝网在加热的情况下将定位焊盘上的多余的焊锡去除。
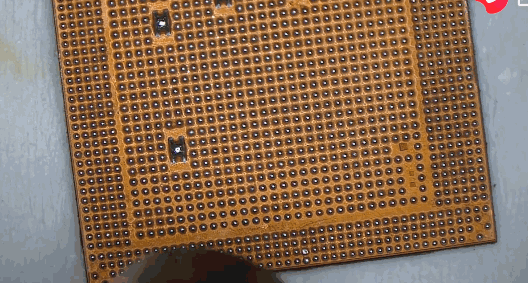
使用吸锡铜丝去掉核心焊盘上的焊锡8. 待芯片冷却后,使用清洗液和软布将芯片表面进行清洗。

清洗芯片9.
由于芯片底部有形成的锡球,所以很容易将软布上的纤维扯下,留在新品管教中,需要对它们进行清理。利用细针剔除在清洗过程中留在芯片表面的纤维。

使用细针提出芯片表面的纤维10. 上述过程中使用过过量的助焊剂,加热过程会在芯片四周形成固体结焦。使用刻刀将芯片四周边缘处的杂质清除。

清理芯片四周的边缘11.
再仔细观察,将芯片表面所遗留的细纤维彻底清除。仔细观察芯片表面,看是否所有的焊锡球均匀。如果有缺损,则需要进行修复。这是考验耐心、眼力的时候。

仔细清理芯片管脚之间的剩余的纤维12. 1000个重生锡球,难免有的锡球有缺损。下面修复过程堪称“神一般的操作”。
对有缺损的焊锡球,也就是在前面工序中,焊锡膏比较少的地方所形成的焊球小。在该焊锡球上增加一些焊锡膏。

在该修复锡球上增加焊锡膏13. 使用热风枪重新加热带修补的焊锡球。此时,如果焊锡膏量比较多,有可能在相邻的两个焊锡球之间形成锡桥。

使用热风枪重新加热芯片管脚14. 在加热的情况下,使用细针在桥连的两个锡桥中间划过,将锡桥断开。这一切都是在加热的情况下进行。

使用尖针在加热状态下断开管脚之间的锡桥15. 下面的过程就是焊接芯片过程了。相比前面使用焊锡膏重生锡球过程,焊接过程到时显得比较轻松了。
将PCB的焊盘表面使用刀口烙铁进行清除,剔除所有的焊锡。然后将芯片放置在PCB焊盘上,对准。

将IC放置在PCB板上16.
使用热风将均匀加热芯片顶部,直到芯片下面和周围的焊盘融化。融化后的锡球开始与PCB板上的焊盘融合,并带动芯片自动对齐。

使用热风机均匀加热芯片使用一个细针轻轻触动芯片边缘,可以发现芯片会自动对齐底部PCB板上的焊盘。

使用针尖推动芯片,使得芯片自动对齐17.
然后再使用助焊剂渗入芯片底部。使用热风枪继续加热。融化和沸腾的助焊剂会进一步增加芯片锡球的流动性。助焊剂的整齐也会微微推动芯片,使其自动对齐PCB板。

使用助焊液提高芯片管脚的流动性18. 当芯片冷却后可以从侧面目测芯片焊接的情况。此时芯片的所有引脚都与底部多层PCB板一一对应焊接成功了。

从侧面目测焊接结果通过观察和学习BGA芯片焊接过程,可以看到,电路板的成功焊接是焊锡、焊盘、热量、助焊剂四者共同作用下的结果。也许并不是所有电子工程师都可以使用放大显微镜精细观察到焊接的所有过程,但我相信只要看过上述焊接视频一次,它就会留在你们的脑海里,潜移默化去影响你在焊接过程中的操作。