全球主导的半导体研究机构与企业在SOT-MRAM蚀刻工艺领域进行了密集的研发活动;然而,实现高效、精确的SOT-MRAM蚀刻工艺仍被视为行业内的关键技术难题之一。
近来,中国科学院微电子研究所于SOT-MRAM关键集成技术领域取得了显著的突破。此次科研成果标志着在这一前沿存储技术方面迈出了坚实的一步。
根据中国科学院微电子研究所的最新公告,为攻克SOT-MRAM的刻蚀技术难关,并实现高密度片上集成的目标,同时深入探索各种刻蚀工艺对磁电性质的影响,集成电路先导工艺研发中心在罗军研究员的带领下,创造性地研发了一种名为“停MgO”的刻蚀工艺。该工艺专为垂直磁各向异性SOT-MTJ设计,成功解决了SOT-MRAM生产过程中存在的刻蚀短路挑战。
课题组精心研发了一种创新刻蚀技术,专为在MTJ结构中精准地终止于约1纳米厚的MgO层。这一工艺设计确保了隧穿层MgO侧壁的完整无损,有效地防止了MgO层的短路现象。通过采用此"停MgO"刻蚀方法,所制备的SOT-MTJ器件阵列在晶圆级上的电阻良率实现了完美提升至百%,同时显著提升了关键性能指标,如器件的巨磁阻效应、电阻和矫顽力等的均一性。
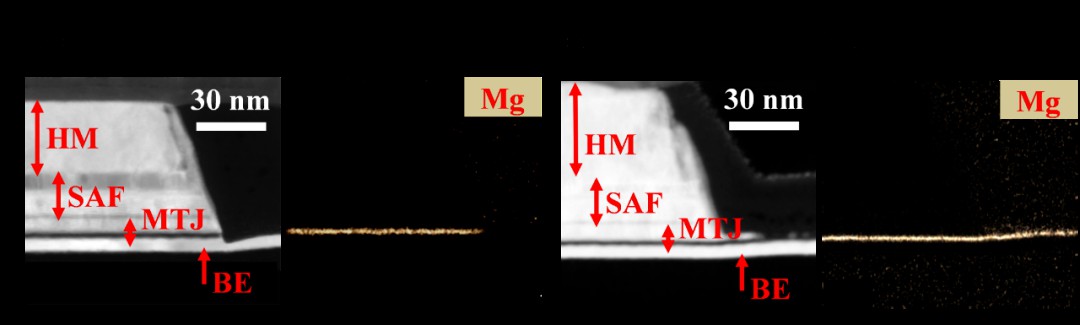
在深入探讨中,"停MgO"器件在热稳定性能方面展现出了显著优势,其热稳定性较之其他同类设备更为出众。此外,该器件的翻转电流密度相较于先前的技术有所降低,这不仅意味着在操作上更加高效,同时也进一步提升了整体性能。令人瞩目的是,它具备极高的翻转速度,最高可达1 ns,这一特征为高速、低功耗以及高集成度的SOT-MRAM刻蚀技术提供了至关重要的突破性解决方案。
此研究成果在微电子领域内具有划时代的意义,不仅解决了高速、低功耗及高集成度SOT-MRAM所面临的刻蚀技术难题,同时也为行业未来的发展开辟了新的可能性。通过引入这一创新技术,我们可以期待在未来看到更加高效、稳定且性能卓越的存储解决方案,这无疑将对整个科技产业产生深远影响。