市场对更高性能、更小尺寸、更低能耗的需求从不止步,然而,随着摩尔定律放缓和先进工艺成本攀升,仅靠制程迭代带来的性能增益有限,需要系统级的优化。在这种需求的推动下,集成电路封装技术也在不断进步,为了满足多样化的应用需求,系统级封装(SiP)和FCBGA两种封装形式应运而生,并迅速成为了电子制造业中的热门选择,为电子产品的设计和制造提供更灵活、更高效的解决方案。SiP实现了高度集成的设计,有效降低了芯片的整体体积,提升了系统性能。FCBGA采用了倒装焊接技术,使得连接更短、更紧凑,从而提高了信号传输速率和可靠性。
因应市场需求,年产能亿颗的摩尔精英无锡SiP先进封测中心于2022年正式量产,为客户提供系统级封装(SiP)从设计到量产的完整解决方案,同时与一线封装基板厂深度合作,提供灵活高效的Flip-chip封装解决方案(FCCSP/FCBGA工程批和量产)。无锡SiP先进封测中心测试车间配置数十套以自主机台为基础的CP/FT测试产能,目前已为20家客户50余款芯片产品完成工程开发和数亿颗芯片的量产测试。
摩尔精英封测协同解决方案 
系统级封装SiP
摩尔精英SiP一站式解决方案,贯穿电路设计到封装量产的产品生命周期,让客户最大化省心省力。客户仅需输入产品功能需求,例如现有PCB原理图,后续的设计和生产可完全交由摩尔来完成,统筹完成原理图设计、芯片选型、元器件选型、SiP设计、生产和测试。目前摩尔精英已服务了包括TCL、中车、长虹在内的多家头部系统厂商,和面向多样化市场的中小方案/模组厂商。
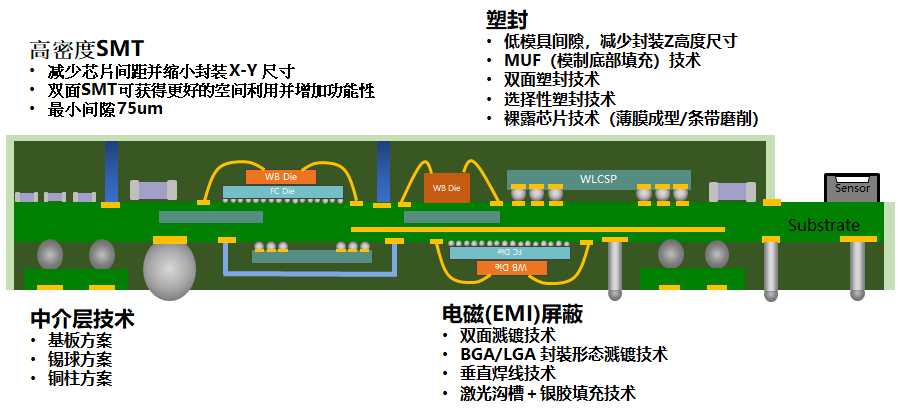
Flip-chip倒装封装
摩尔精英无锡SiP先进封测中心提供面向DPU、HPC、CPU、GPU、高端服务器、高性能ASSP、FPGA等产品的Flip-Chip封装完整解决方案,包括封装设计、仿真、工程批和量产。FCBGA整体产能可达1KK每月。

技术能力,基板资源,摩尔精英与一线封装基板大厂深度合作,支持最高6~16层基板的生产,为客户提供打样到量产产能保障。
成功案例,Flip-chip封装成功案例