来源:星际浮尘
注入增强型IGBT
1、结构特点与典型工艺
1.1结构提出与发展
为了协调IGBT通态特性与关断特性及短路特性之间的矛盾,提高器件的综合性能和可靠性,在IGBT中引入了一种电子注入增强效应(Injection Enhancement Effect,IE),既可加强IGBT导通时的电导调制效应,又可限制阳极空穴的注入,于是形成了注入增强型IGBT(Injection Enhanced Insulated Gate Bipolar Transistor,IE-IGBT)。
尽管出现了很多结构,所采取的措施也不同,但目的都是提高通态时IGBT内部发射极侧的载流子浓度,即引入IE效应,以增强电导调制作用,从而解决IGBT通态特性和开关特性之间的矛盾,降低器件功耗。
1.2结构类型与特点
按栅极结构分:平面宽栅、沟槽宽栅、平面-沟槽栅(Trench-Planar Gate,TP)结构
按是否有虚拟元胞分:普通元胞和虚拟元胞结构
按辅助层的位置分:沟槽栅结构(如CST-BT)和平面栅结构(如EP-IGBT和HiGT)
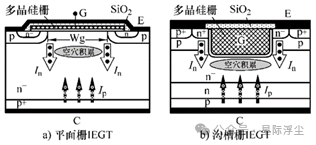
图1 IEGT结构
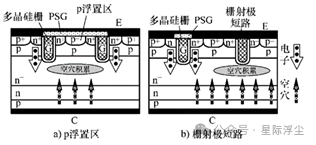
图2 含虚拟元胞的窄槽栅IEGT结构
(1)宽栅IEGT结构
集电极注入的空穴在宽栅形成积累,引起发射极向漂移区注入的电子增强。
由于这两种结构的栅极尺寸较大,使得元胞密度和沟道密度减小,从而会影响器件的电流容量。
(2)虚拟元胞窄槽栅IEGT结构
部分元胞的p基区没有欧姆接触,成为p浮置区。导通期间,集电区注入的空穴将无法经过p浮置区到达发射极,于是会在p浮置区下方的n-漂移区内形成积累。
部分元胞的多晶硅栅极与发射极短路,导通期间,栅极两侧的p基区则不会形成导电沟道,于是从集电区注入的空穴无法与电子复合,也会在栅极下方的n-漂移区内形成堆积。
(3)n辅助层平面栅结构
HiGT结构通过离子注入工艺在n-漂移区和p基区之间形成一个n空穴势垒(HB)层,其掺杂浓度略高于n-漂移区的掺杂浓度,使得p基区与n辅助层间的内电位差增加了约0.2V,相当于增加了一个空穴势垒。导通期间大量空穴会积累在空穴势垒层下方,迫使n+发射区注入增强。该结构不需要像P-IEGT那样增加栅极宽度,就可获得较强的IE效应,但对n HB的掺杂浓度要求极为严格,设计不当会严重影响器件的阻断能力。
EP-IGBT结构是在普通平面栅P-IGBT的p基区侧面和底部分别增加了一个n增强层。与HiGT结构相比,EP-IGBT除了具有IE效应外,阻断电压较高;同时p基区侧面的n增强层会缩短沟道长度,有利于提高器件跨导和集电极电流,降低MOS沟道的压降。通过优化n增强层的参数,可增大其反偏安全工作区(RBSOA)。
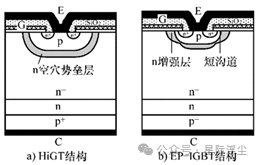
图3 平面栅结构
(4)n辅助层沟槽栅结构
CSTBT结构是在p基区与n-漂移区之间增加一个n载流子存储(CS)层, 类似于HiGT结构中的n HB层。导通期间在n CS层下方会形成空穴积累层。如将n CS层和虚拟元胞相结合,可形成CSTBT结构,导通期间的IE效应会更强,从而获得更低的导通损耗和开关损耗。
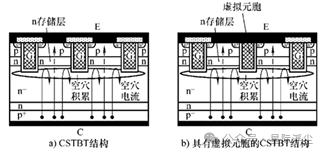
图4 沟槽栅结构
图5a为东芝公司4.5kV P-IEGT芯片,尺寸为15mm×15mm,栅极压焊点均位于芯片角处。图5b为日立公司3.3kV/50A平面栅HiGT芯片,栅极压焊点位于芯片中央。图5c为三菱公司1.2kV/150A沟槽栅CSTBT芯片,栅极压焊点位于芯片的侧边和角上。
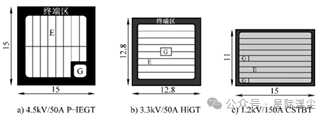
图5 各种不同IE-IGBT结构的芯片图形
1.3典型工艺
IE-IGBT关键工艺在于深而窄的沟槽刻蚀、n辅助层的注入技术及少子寿命控制技术。
(1)沟槽刻蚀工艺
在沟槽栅IEGT结构中,沟槽越深(约12μm),IE效应越强。为了消除栅氧化层不均匀引起的阈值电压变化,并提高MOS沟道电子的迁移率,需采用精细的RIE刻蚀工艺先形成沟槽,再生长牺牲氧化层来获得光滑的槽壁。对于宽槽栅(槽宽为8~12μm)结构,通常在氮氧化硅(SiON)掩蔽下进行沟槽刻蚀之后,再采用局部氧化(LOCOS)工艺来圆化沟槽底部拐角,并消除顶部的“鸟嘴”效应。
(2)n辅助层工艺
若采用常规掺杂工艺,由于存在杂质的补偿作用,会使沟道的净掺杂浓度降低,导致阈值电压下降,并影响沟道电子的迁移率,同时也很难形成掺杂浓度和厚度均合适的n辅助层。采用倒掺杂(Retro Grade Doping)工艺,可有效避免CS层对沟道掺杂浓度的补偿,有利于获得更高的沟道电子迁移率,并提高器件的均匀性,增大短路安全工作区(SCSOA)。
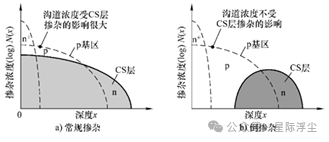
图6 载流子存储层的掺杂浓度分布
(3)载流子寿命控制技术
寿命控制技术改善IEGT开关特性,也会影响器件IE效应的强弱。与传统的均匀寿命控制相比,采用局部寿命控制,如质子辐照和H+、He2+等轻离子辐照,可将低寿命区控制在靠近n缓冲层的n-漂移区中,从而使器件的开关特性和通态特性同时得到改善。
2、工作原理与注入增强效应
2.1工作原理
无论是采用宽栅结构,还是虚拟元胞,或者增加n辅助层,都增强了发射极侧的载流子注入,使得器件内部的电导调制区域由局部的n-漂移区扩展到整个n-漂移区甚至n型辅助层中。所以,IE-IGBT具有比普通IGBT更好的通态特性。在采用n辅助层和虚拟元胞的复合结构中,IE效应会更加明显,电导调制区域更大,器件的特性会进一步改善。
2.2等效电路
IGBT可等效为MOSFET和pnp晶体管的级联,在导通状态下,IGBT可简化地等效为MOSFET和pin二极管的串联。
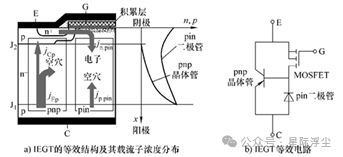
图7 IEGT导通状态下的等效结构及其载流子浓度分布与等效电路
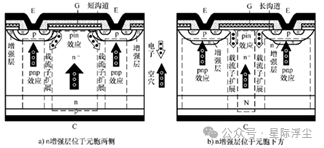
图8 EP-IEGT结构中的pin二极管与pnp晶体管效应
如图8a所示,当n增强层位于元胞两侧时,沟道缩短,n+发射区的电子通过沟道后向元胞下方扩展,在栅极正下方的n-漂移区形成空穴积累,使pin二极管的效应加强。图8b当n增强层集中在元胞底部时,此时沟道长度不变,n+发射区的电子通过沟道后向栅极下方扩展,同时空穴会在元胞正下方的n增强层处形成积累,使pnp晶体管效应加强。
为了获得优良的导通特性,应加强P-IEGT内部的pin二极管效应。 但如果发射区附近的pin二极管效应增强,饱和电流特性变差。所以,为了获得优良的FBSOA,pin二极管效应需远离沟道和发射区。如图9所示的沟槽-平面栅TP-IEGT结构,在发射极元胞之间插入了沟槽(类似于TPMOS),于是沿沟槽侧壁会形成电子积累层,同时因沟槽和元胞之间的n-漂移区很窄,空穴只能在元胞下方的n-漂移区形成积累,产生电子注入增强效应,使pin二极管效应增强,并且pin二极管效应仅压缩在远离发射区的n-漂移区内,故TP-IEGT具有比P-IEGT更好的导通特性。
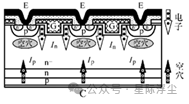
图9 沟槽平面栅IEGT
2.3注入增强效应及其表征
但IE效应起因于n-漂移区存在空穴积累,从集电区注入到n-漂移区的空穴数目并没有增加。可见,IE效应能方便地增加IE-IGBT发射极侧的电子积累,同时有效地控制集电极侧的空穴注入,因此很好地解决了IGBT耐压提高时关断特性与通态特性之间的矛盾。
可用发射极电子注入效率γn来表征IE效应的强弱。γn越大,IE效应越强,器件的通态特性越好。γn值不仅与MOSFET表面迁移率有关,还与栅极结构、集电极注入效率及发射极面积等因素有关。
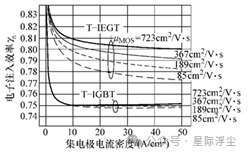
图10 T-IGBT和T-IEGT的注入效率比较
沟槽栅IEGT和IGBT的电子注入效率比较如图10。两者的电子注入效率都随集电极电流密度的增加而减小,随沟道电子迁移率μns的增加而增加。T-IEGT的电子注入效率明显高于T-IGBT,并且随沟道电子迁移率的变化更加明显,这说明要提高T-IEGT的电子注入效率γn,必须提高MOS沟道的电子迁移率。
图11给出了P-IEGT和T-IEGT的电子注入效率与结构参数的变化关系。T-IEGT电子注入效率(γn≈0.75~0.83)明显高于P-IEGT(γn≈0.73~0.77),并且γn除了与MOS沟道电子的迁移率有关外,还与元胞宽度和沟槽栅尺寸有关。P-IEGT的γn随元胞半宽度W的增大呈线性增加,T-IEGT的γn随深度T和元胞半宽度W乘积的平方根增大呈非线性增加。
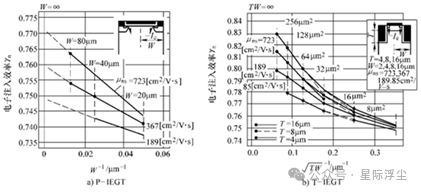
图11 P-IEGT和T-IEGT的电子注入效率γn与结构参数的关系曲线
3、静态与动态特性
3.1通态特性
P-IEGT的饱和电压主要由漂移区的压降Un-和集电结的压降Up+n决定。

式中JC为集电极电流密度;Wn-为n-漂移区厚度;ρc和ρe分别为集电极和发射极侧载流子浓度。
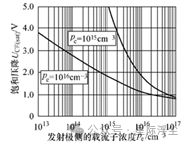
图12 T-IEGT的UCEsat随ρe和ρc变化曲线
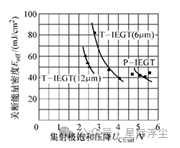
图13 P-IEGT与T-IEGT特性比较
当集电极侧载流子浓度ρc一定时,UCEsat随ρe的增加而下降;当ρe一定时,ρc越高,UCEsat越低。适当提高IEGT集电极侧与发射极侧的载流子浓度,有助于实现理想的低饱和电压,但集电极侧的载流子浓度增加会导致关断特性变差。
3.2特性比较
图13所示为采用局部少子寿命控制的P-IEGT与T-IEGT关断能耗密度与饱和电压UCEsat的关系。P-IEGT的UCEsat明显比T-IEGT的要高,并且沟槽越深,对改善T-IEGT关断特性与饱和电压越有利。
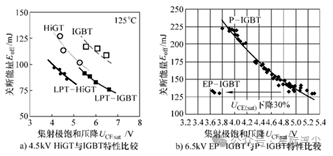
图14 几种不同结构的IE-IGBT特性的比较
采用LPT型耐压结构可进一步改善平面栅IE-IGBT的综合特性。图14a对4.5kV器件而言,当关断能量Eoff一定时,LPT-HiGT的饱和电压更低,而普通IGBT特性最差。图14b对6.5kV器件而言,当Eoff一定时,EP-IGBT的UCEsat比普通IGBT低30%。如果将沟槽栅n辅助层及LPT型结构相结合,可以获得更好的综合特性。如LPT-CSTBT结构的饱和电压比传统P-IGBT结构的下降约40%,并且耐压越高,CSTBT与传统P-IGBT结构的特性差异越大。